めっき技術 TECHNOLOGY
開発技術
Line/Bump plating or under-barrier electroplating on the semiconductor water
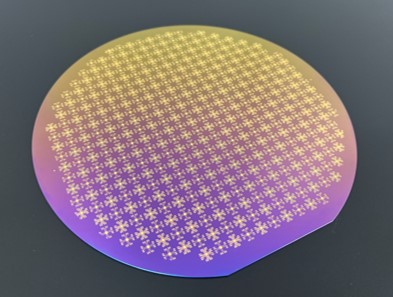
めっきによるマイクロバンプや微細配線は、半導体パッケージなどの微細化、高機能化に不可欠な技術です。
20年以上の開発と経験で培った半導体ウエハへのめっき技術を駆使し、お客様の課題解決、製品実現に貢献します。
最小1枚~の少量試作や検証案件にも対応可能です。量産案件もご相談ください。
■対応基材
サイズ:4・6・8・12インチ ※左記以外のサイズも相談ください
素材:Si、SiC、GaAs、InP、ガラス、サファイヤ、セラミックス、その他化合物半導体
| 電解銅(Cu) | 配線、再配線(RDL)、ハイブリット接合、デュアルダマシン、Cu焼結接合、低抵抗化、放熱性 |
|---|---|
| 電解ニッケル(Ni) | バリアメタル(拡散防止) |
| 電解金(Au) | 半田接合、ワイヤーボンディング接合、Au-Au接合、ACF接合、耐酸化性、低抵抗化 |
| 電解スズ-銀(SnAg)合金 | 鉛フリーでの接合 |
| 電解金-スズ(AuSn)合金 | 高温接合 |
| 電解ロジウム(Rh) | 表面硬度、耐摩耗性 |
| 電解インジウム(In) | 低温接合 |
※上記以外の仕様についてもお気軽にご相談ください
お客様の製品設計/用途/課題に合わせ、最適なバンプ・配線・Padめっき技術をご提案いたします。
まずは、お気軽にご相談ください。
・めっき種:Cu、Ni、Au、SnAg、AuSn、In、Rhなど
※Cu/Ni/Au、Cu/Ni/SnAg、Ni/Au、Cu/SnAgなどご要望に合わせ様々な組み合せに対応します。
※上記にない膜種もご相談ください
・めっき膜厚:ご要望/用途に合わせ薄膜~厚膜(MAX100μm程度)まで対応します。
・製品基材 :Φ4~12インチまで対応
※上記以外のサイズ、100μmレベルの薄型ウエハ、四角形状、特殊材料/形状はご相談ください。
・バンプ・配線などのパターニングめっきだけでなく、全面めっきにも対応します。
~詳細対応内容については、ダウンロード資料ご覧ください~
バンプ・配線形成において、めっきのみはもちろん、その前後工程となる、スパッタによるシード層の形成や、露光/現像によるレジストパターニング、レジスト・シード層剥離⼯程まで、当社は関連する設備・技術を保有しており、⼀貫工程での対応も可能です。ワンストップで加工ができるため、お客様の設計期間短縮にも貢献します。
・スパッタ :Ti,Cu,Al,Niの薄膜シード層作成が可能です。
※膜厚・層構成はご要望に合わせ対応します。
・フォトリソ :露光装置はアライナータイプで、マスク作成から対応可能です。
・電解めっき :前項をご覧ください。
・レジスト剥離:レジスト材質に合わせた剥離が可能です。
・シード剥離 :スパッタ形成したTiやCuのシード層をエッチングします。
サイドエッチングを抑えた選択的なエッチングが可能です。
当社一貫プロセスでは、マイクロバンプ、微細配線を形成できます。
・最小バンプサイズ:Φ10μm×H10μm
・最⼩配線ライン :L/S=10μm/10μm×H15μm
めっき工程のみの場合、より微小・微細パターンの加工実績がございます。
・最小バンプサイズ:Φ5μm以下
・最小配線ライン :L/S=3/3μm以下
※めっき膜厚や形状によって対応が異なりますので、ご相談ください。
※詳細対応内容については、ダウンロード資料ご覧ください
3次元実装・高密度実装に必要となる座繰り基板の場合でも、基板の高低差に追従した配線めっきが可能です。
・配線幅は、最小30μmまで対応
・深さ300μmの急勾配にも配線形成
※座繰りの勾配・形状により対応が異なりますので、ご相談ください。
■ウエハサイズ・工程別対応一覧
■バンプ径・高さ別対応一覧
■バンプめっき加工事例
■配線めっき加工事例
ウエハのような丸形状だけでなく、分割形状、チップ形状でも対応できますか?
形状によって対応が可能な場合がございますので、ご相談ください。
上記にないめっき種類・仕様の加工は可能ですか?
内容によって対応可能な場合がございますので、ご相談ください。
準備等によりお時間を頂く場合もございます。
基材の厚みが薄くても対応は可能ですか?
材質にもよりますが、100μmレベルの厚みですと実績がございます。
スパッタのみ、フォトリソのみ、剥離のみなど、めっき以外の部分的な加工は可能ですか?
対応は可能です。一部内容によっては対応不可の場合もございますので、ご相談下さい。
フォトリソ用の露光マスクは、どのように作成されますか?
お客様から図面データをいただき、マスクの作成手配をさせていただきます。
図面データ形式としては、DXFかDWG形式をお願いしております。